研究背景
GaN宽禁带半导体在光电器件、高频高功率电力电子器件和微波射频器件等领域具有广泛的应用。在制备这些GaN基器件时,需要低位错密度的GaN衬底。为获得低位错密度自支撑GaN衬底,采用了不同的材料生长方法,包括氢化物气相外延法(HVPE)、钠助熔剂法、氨热法等。尽管近些年GaN单晶质量已经大大得到提高,但是高密度位错仍然限制了功率器件的广泛应用潜力。目前,穿透位错在GaN生长过程中的演化机制,位错如何影响器件性能等问题仍尚未解决。
GaN中位错主要为穿透位错(TDs),朝c轴方向延伸。根据伯格斯矢量,穿透位错可以分为刃位错(TED, b=ma)、螺位错(TSD,b=nc)和混合位错(TMD,b=ma+nc);无损伤缺陷表征方法有X-射线3D形貌(topography)、阴极荧光谱(CL)、光学光谱等。研究表明,HVPE生长的GaN衬底中大多数位错可以用腐蚀坑方法、CL、单光子荧光谱(PL)方法表征(如图1),但是也有些位错用CL方法无法识别,而在PL成像中却可以观察到。CL谱中电子束在GaN中的穿透深度约为200 nm (电子束能量 5 kV);PL谱中的紫外光源在GaN中穿透深度也约为200 nm(光源波长310 nm),因此,CL成像和单光子PL成像只能表征样品表面位错的分布特征,对表面处理、表面粗糙度等非常敏感。多光子荧光(MPPL)成像技术采用长波长激光,受样品表面粗糙度等因素干扰少,且激发光源能够入射样品深度100-200 μm,可以对位错进行三维成像。

图1. HVPE生长的GaN单晶衬底腐蚀坑荧光PL成像(a)、阴极荧光CL成像(b)和光学成像(c)。大部分位错在PL和CL下具有一一对应的关系,但是有些位错在CL成像中无法识别,确能在PL成像中出现(图中红色箭头处)[1]。
多光子荧光三维成像原理
不同于传统单光子PL,多光子荧光采用长波长激发,远大于带边荧光波长。激发过程需要同时吸收二个或者多个光子(图2)。通过吸收多个脉冲光子,在导带和价带形成电子空穴对,随后非辐射驰豫到导带底和价带顶,最后产生带边发光(3)和缺陷发光(4)。通过滤波片获得带边和缺陷发光光谱和光强,改变入射光斑的位置,从而得到样品的荧光信号三维分布,即三维成像。在位错处形成的非辐射衰减通道,使得其荧光信号较弱,因而形成暗斑(图2c)。双光子吸收系数正比于激发光强度的平方,荧光只是在激光聚焦点处产生。空间分辨率由少数载流子扩散长度和激发体积决定。少数载流子的扩散长度在亚微米量级,激发体积由光学系统决定,使用数值孔径为0.8的聚焦镜头时,平面内空间分辨率能达到0.3 μm, 而纵向方向分辨率为3 μm左右。
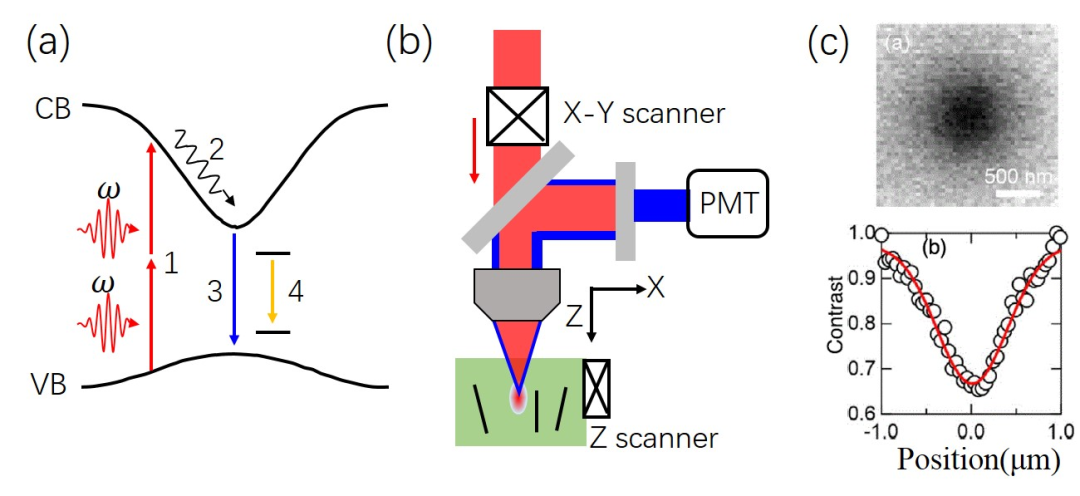
图2. 多光子荧光(MPPL)三维成像原理图。
(a)通过吸收多个脉冲光子,在导带和价带形成电子空穴对(1),非辐射驰豫到导带底和价带顶(2),产生带边发光(3)和缺陷发光(4)。(b) MPPL装置示意图。在样品内部的激光聚焦点处产生荧光,通过改变聚焦点的位置实现三维成像。(c) MPPL在位错处成像。在位错处形成非辐射中心,荧光强度降弱,形成一黑斑(dark spot)。
GaN穿透位错三维成像和分类
非线性多光子荧光成像技术被广泛应用于生命科学、生物医学等领域,用于可视化观察生物体内活体组织。应用该技术研究半导体材料目前在初步阶段,用该无损伤三维表征技术研究宽禁带半导体材料(GaN、SiC和金刚石等)的缺陷位错具有非常重要的意义。文献[2]采用激发波长在700 nm, 脉冲宽度为100 fs的钛宝石锁模激光器,研究了在蓝宝石衬底上生长的GaN位错分布。在激光聚焦深度(z)处,进行双光子荧光(2PPL)二维(x-y)平面成像。通过改变不同聚焦深度,得到一系列平面成像图,并组合构成了32x32x135 μm3三维图像(图3)。平面内位错密度低于1x108 cm-2时,可以空间上分辨单个位错。2PPL三维图像显示,大多数位错沿垂直于生长面方向延伸。图3e表明,随着GaN外延层增厚,一些位错湮灭,位错密度逐渐减少。

图3. 双光子荧光(2PPL)三维成像GaN位错。HVPE在蓝宝石上外延生长的GaN薄膜,分别在不同的聚焦深度,如表面z=0 μm (a); z=50 μm (b);和z=100 μm (c),相应的x-y平面内位错成像,以及三维成像(d)。为可视化位错,图d中将信号强度对比反转,将位错线作为白线显示。(e)用厚度为160 μm(红圈)和 320 μm(蓝圈)GaN薄膜,双光子成像测量位错密度随厚度变化。拟合曲线为位错湮灭模型[2]
非线性多光子荧光三维成像技术可以识别和区分不同类型的位错。日本大阪大学采用波长为1030 nm的飞秒激光,基于三光子显微成像研究了GaN位错[3]。与腐蚀坑位错表征方法比较,多光子荧光成像不仅反映在样品表面位错位置(腐蚀坑)的一一对应的关系,而且能表征腐蚀坑下面的位错传输特性(图4)。表面小型腐蚀坑(S、M)分别对应TED、TSD和TED等位错,MPPL纵向截面成像表明位错形貌为线性形状,而在大型腐蚀坑(直径大于2 μm)下面,相近的位错线有交互作用,导致复杂的传输特性。
GaN中位错可以用两个方位角表示,即与c轴的夹角θ以及与a轴的方位角φ。图4b 给出了位错两个方位角θ和φ的关联统计。位错的倾斜角θ>4°,对应的φ值为60°倍数,即具有六重对称性。位错的倾斜角大小由最低弹性应变能决定,位错倾斜角θ>4°确定为混合位错TMD。大多数位错倾斜角θ<4°,为刃位错TED和螺位错TSD,进一步从多光子荧光强度对比值区分二者,TED荧光强度对比值少于0.37,而螺位错TSD对比值大于0.37(图4c)。因此,多光子荧光三维成像技术能够对外延GaN晶体中三种位错TED、TSD、TMD进行统计分类和区别,表明该无损伤探测技术识别位错伯格矢量的可行性。
几乎与文献[3]同时,日本大阪大学另一课题组报道了在钠助熔剂法生长的GaN衬底上用HVPE法同质外延GaN体单晶穿透位错的研究[4]。采用多光子荧光三维成像技术,研究表明在同质外延GaN体单晶中三种类型位错TED、TSD、TMD倾斜角统计规律与异质外延GaN体单晶一致。在异质外延GaN体单晶表面,多光子荧光成像会出现六角对称的亮条纹和’V’型亮条纹,结合AFM表明是由于在晶体表面形成了对称的六角小丘(hillock)和非对称三角小丘,亮条纹对应于小丘的山脊(ridges)。多光子荧光成像有利于我们增加对GaN体单晶中位错基本特性的理解。

图4.GaN位错三维成像统计分析。(a) GaN位错表面腐蚀坑光学显微成像与MPPL成像对照图,以及位错沿纵向(z轴)MPPL成像截面图。(b)位错方向角φ和θ的关联统计图。(c) 位错沿c轴的倾斜角θ与MPPL强度对比值的关联统计,可以分为刃位错TED、螺位错TSD和混合位错TMD[3]。
展望
进一步跟传统位错表征手法,例如TEM, CL和腐蚀坑方法等对比分析,同时也需要从多光子荧光成像系统进行优化和完善。多光子荧光无损伤表征技术将有助于制备高质量GaN体单晶,有利于GaN基器件的发展。
参考文献
1.Y. Yao, Y. Ishikawa, M. Sudo, Y. Sugawara, D. Yokoe, Characterization of threading dislocations in GaN (0001) substrates by photoluminescence imaging, cathodoluminescence mapping and etch pits. J. Cryst. Growth 468, 484(2017).
2. T. Tanikawa, K. Ohnishi, M. Kanoh, T. Mukai, T. Matsuoka, Three-dimensional imaging of threading dislocations in GaN crystals using two-photon excitation photoluminescence. Appl. Phys. Express 11, 031004(2018).
3. M. Tsukakoshi, M. Tanikawa, T. Yamada, M. Imanishi, Y. Mori, M. Uemukai, R. Katayama, Identification of Burgers vectors of threading dislocations in freestanding GaN substrates via multiphoton-excitation photoluminescence mapping. Appl. Phys. Express 14, 055504(2021).
4. T. Hamachi, T. Tohei, Y. Hayashi, M. Imanishi, S. Usami, Y. Mori, N. Ikarashi, A. Sakai, Propagation of threading dislocations and effects of burgers vectors in HVPE-grown GaN bulk crystals on Na-flux-grown GaN substrates. J. Appl. Phys. 129, 225701(2021).
图片来源
来源上述参考文献并略有改动





