研究背景
在GaN HEMT结构中,异质界面的极化差异产生了二维电子气(2DEG)。异质界面处的组分、应力、缺陷等差异决定了2DEG的形成和分布,进而影响器件性能。因此实现器件内部2DEG分布的直接观测具有重要意义。由于GaN HEMT异质结构存在显著的应力,传统的测试分析技术无法有效观测到2DEG的分布。
近年来,科研人员在差分相位衬度-扫描透射电子显微成像 (DPC-STEM)技术的基础上发展出了倾斜扫描平均DPC-STEM(tDPC-STEM)技术,该技术利用实验获得的差分相位对比信号提取真实的电磁场信号,能够抑制衍射衬度,从而改善针对GaN HEMT结构中2DEG的成像效果。
研究进展
最近,来自日本东京大学的研究团队利用tDPC-STEM技术,成功实现了对2DEG的可视化观测。
DPC STEM在每个光栅位置测量入射电子在样品内感应出的电磁场导致的动量转移,这里我们简单讨论电场的情形。图1显示了DPC STEM技术与tDPC-STEM技术的对比。DPC STEM技术如图1a所示,当一个良好聚焦的电子探针扫描样品区域时,在电场的作用下,库伦力导致电子向右侧发生偏移。偏移的程度可以通过测量明场像模式下中心的质量来确定。如图1b所示,由于在整个样品范围内,局部的散射条件发生变化,因此明场像模式下强度发生波动,这种局部散射的强度上的波动与电场的作用叠加,因此削弱了对电场的观测效果。tDPC-STEM技术如图1c所示,通过对多束测试结果进行平均,可以消除局部散射波动的影响。
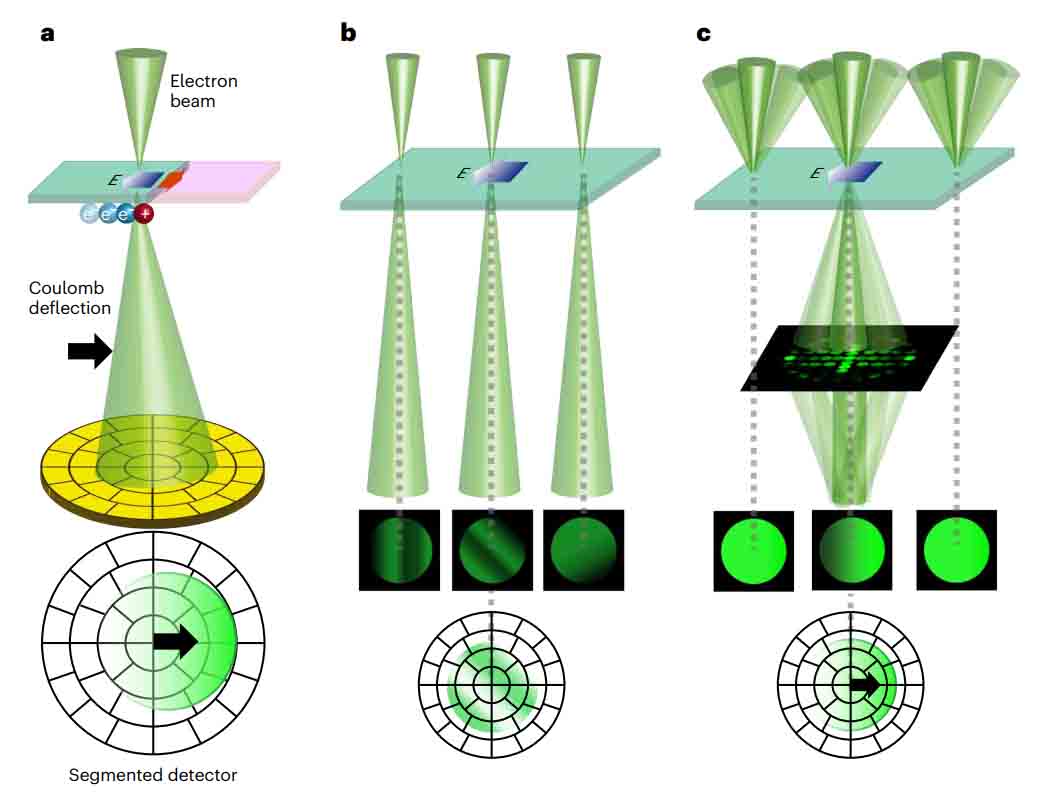
图1 DPC STEM技术和tDPC-STEM技术的示意图
利用tDPC-STEM技术,对近晶格匹配GaN/Al0.81In0.19N(LM-AlInN)样品和赝晶GaN/Al0.88In0.12N(PM-AlInN)样品中的2DEG进行了观测。图2显示了GaN/LM-AlInN和GaN/PM-AlInN样品的能带图,GaN/LM-AlInN样品的HAADF-STEM图像和EDS元素测试结果。这些结果表明在样品的异质界面处没有额外的结构缺陷存在。

图2 GaN/LM-AlInN和GaN/PM-AlInN样品的能带图,HAADF-STEM图像和EDS元素测试结果
GaN/LM-AlInN和GaN/PM-AlInN样品的tDPC-STEM测试结果如图3所示。图3a和b显示了测试过程中样品的晶向;图3c和d为利用tDPC获得的水平(X)方向的电场分量成像;图3e和f为垂直(Y)方向的电场分量成像;图3g和h为投影电场矢量彩图,其中颜色代表电场矢量方向,饱和度代表电场矢量强度;图3g和h显示了计算获得的样品中的电荷密度。图中所有的标尺长度为20nm。
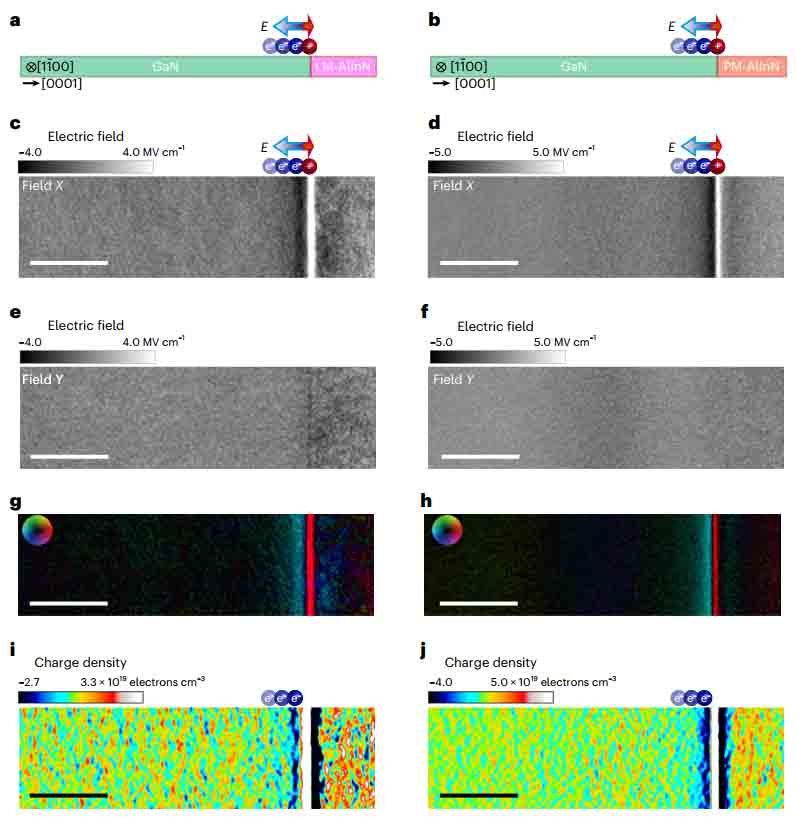
图3 GaN/LM-AlInN和GaN/PM-AlInN样品的tDPC-STEM测试结果
图4显示了采用tDPC-STEM测试得到的实验结果与根据Poisson方程计算得到的仿真结果之间的对比。其中,图4a显示了利用tDPC-STEM测量获得的横向电场分布,图4b显示了基于图4a获得的电荷密度分布实验结果;图4c和4d显示了根据Poisson方程计算得到的仿真结果。尽管存在一定的误差,当前的结果表明tDPC-STEM技术能够对半导体异质结界面处2DEG的局部分布实现定量化分析。
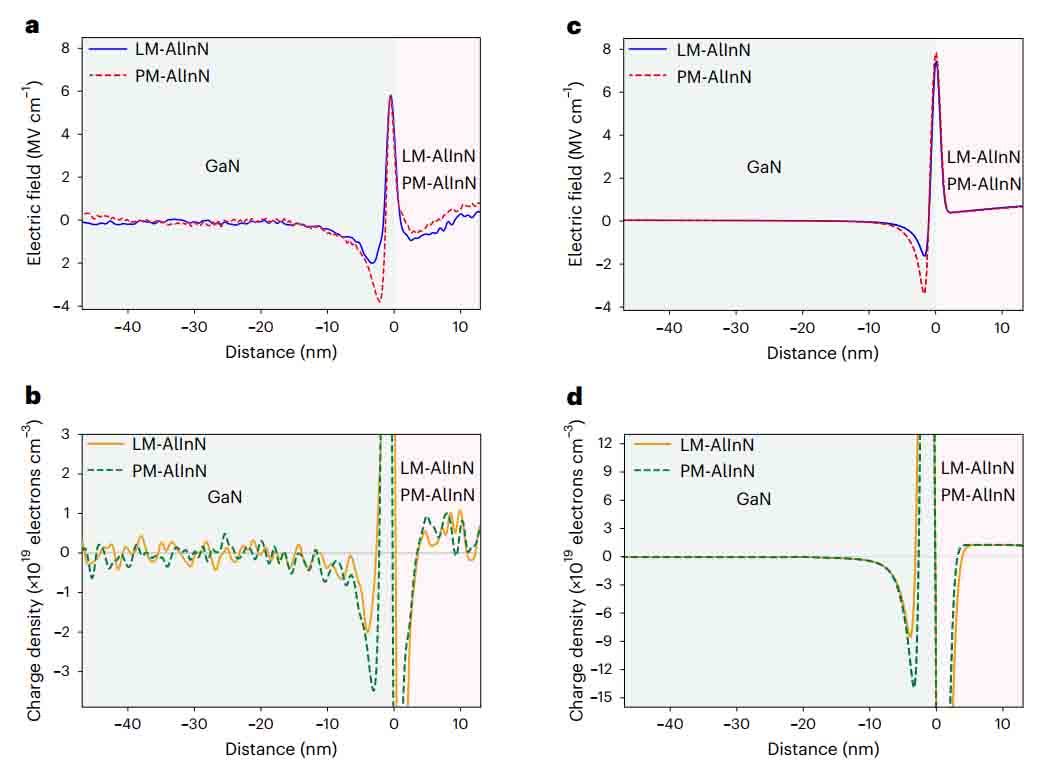
图4 tDPC-STEM实验结果与Poisson仿真结果的比较
利用采用tDPC-STEM技术可以实现在纳米尺度对GaN HEMT器件中2DEG的直接观测,通过对异质界面处的电场强度进行直接测量,对测量结果进行处理后就可以获得异质界面区域内的电荷分布。除了GaN基半导体,该技术还可以用于其它材料和器件。该技术有助于提升对利用2DEG的器件的理解和性能改进。
参考文献
Toyama, S., Seki, T., Kanitani, Y. et al. Real-space observation of a two-dimensional electron gas at semiconductor heterointerfaces. Nat. Nanotechnol. 18, 521–528 (2023). https://doi.org/10.1038/s41565-023-01349-8
图片来源
文中图片来源上述参考文献,网络





