背景介绍
在高频和大功率应用领域中,基于宽禁带材料的高电子迁移率晶体管(HEMT)展现出了巨大的潜力。特别是,位于AlGaN/GaN异质结界面的二维电子气(2DEG)因其卓越的载流子迁移率而被广泛应用于射频(RF)设备中。然而,传统的肖特基栅极结构虽然能够最大化地诱导电荷并提高电流,但也导致了较高的泄漏电流问题。通过引入常规介电层可以减少泄漏电流,但这又会导致导通电流的降低,形成了一个难以调和的矛盾。
文献概述
这篇由Asir Intisar Khanl等人发表于《Science》杂志上的文章提出了一种新的解决方案,通过使用一种铁电HfO2-ZrO2双层作为栅极介质,在保持甚至增加导通电流的同时显著降低了泄漏电流。该研究团队采用这种新方法制作的氮化镓HEMT不仅克服了传统肖特基栅HEMT的局限性,还提供了一条提升基于2DEG的晶体管性能的新途径。
该方案通过引入铁电材料的负电容效应,突破了传统 HEMT 的性能极限。这一成果的意义体现在:
理论层面:验证了负电容效应在高频高功率器件中的可行性,为半导体器件物理提供了新的研究方向。
应用层面:新型器件可直接应用于5G基站功率放大器、新能源汽车电机控制器、航空航天雷达等场景,降低功耗的同时提升设备性能。
产业层面:HZO材料与现有GaN工艺兼容,无需大规模改造生产线即可实现量产,加速了技术落地进程。
附图展示
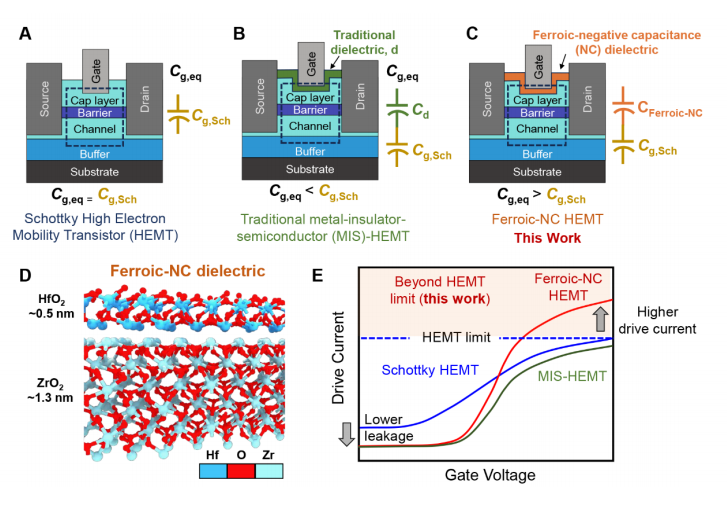
图1 器件结构对比图
在图1中,(A)肖特基HEMT的横截面示意图,其等效栅电容(Cg,eq)对应底层栅堆栈的总电容(Cg,Sch);(B)在栅堆栈中引入传统绝缘栅介质将器件转变为金属-绝缘体-半导体(MIS)HEMT,虽然降低栅漏电流,但由于串联电容效应会使总栅电容低于Cg,Sch;(C)在肖特基构型中引入铁电氧化物介质可在保持低漏电特性的同时,使栅电容突破肖特基极限(Cg,Sch);(D)本工作采用的铁电负电容介质示意图,由ZrO2(1.3nm)/HfO2(0.5nm)超薄双层组成(简称~1.8nm HZO)。(E)铁电负电容HEMT、肖特基HEMT和MIS-HEMT的驱动电流-栅压传输特性对比示意图。负电容HEMT利用增强的电容和栅控能力,在降低关态漏电流的同时实现超过肖特基HEMT极限的更高导通态驱动电流。

图2 HZO材料与栅极电容关系
在图2中,肖特基与负电容(NC)GaN HEMT结构及材料表征。(A)制备的肖特基GaN HEMT示意图。"肖特基"指栅金属与凹槽GaN覆盖层之间不存在任何栅介质。(B)钨(W)栅金属下方肖特基HEMT堆栈的透射电镜横截面图像(切割线如(A)中虚线箭头所示),显示约4nm厚的凹槽GaN覆盖层。(C)制备的NC GaN HEMT示意图,在栅金属(W)与凹槽GaN覆盖层之间具有铁电负电容HZO介质。(D)栅金属下方NC HEMT的透射电镜横截面显微图(切割线如(C)中虚线箭头所示),显示在约4nm剩余GaN覆盖层(与肖特基GaN HEMT厚度相同)上存在约1.8nm HZO栅介质。原子级1.8nm厚HZO介质的图像及从橙色框区域提取的d晶面间距表明:(E)萤石结构铁电正交相(Pca21)与(F)反铁电四方相(P42/nmc)共存于同一HZO层中,促进负电容效应的稳定。(E)和(F)中的HZO层采用与器件完全相同的沉积条件,物相归属基于Zr(Hf)的原子构型及其原子间距。铁电正交相(Pca21)沿[100]晶带轴与反铁电四方相(P42/nmc)沿[111]晶带轴的原子构型分别示于(E)和(F)。
总结
该研究通过引入铁电HfO2-ZrO2双层作为栅介质,成功实现了同时提高导通电流和降低泄漏电流的目标,这对于未来高性能电子器件的设计具有重要意义。这项成果不仅为解决长期存在的技术难题提供了新思路,也为进一步探索负电容效应的应用开辟了道路。
文献信息
标题:Negative capacitance overcomes Schottky-gate limits in GaN high-electron-mobility transistors
作者:Asir Intisar Khanl et al.
期刊:Science
DOI: 10.1126/science.adx6955
江苏第三代半导体研究院译





