高质量氮化镓 (GaN) 单晶衬底是发展高性能和高可靠性氮化镓基器件的关键,但由于GaN在其熔点时(2300 ℃)时的分解压高达6 GPa,常规的熔体法单晶生长技术,如Bridgman法、直拉法及区熔法等难于应用于GaN单晶的生长。目前生长GaN单晶的方法主要有氢化物气相外延法(HVPE)、氨热法(Ammonothermal)和助熔剂法(Na Flux Method),其中HVPE方法生长速率快、易得到大尺寸晶体,是目前商业上生产GaN单晶衬底的主要方法。
氨热法是一种在高温高压(400~750 ℃,1 000~6000个大气压)从超临界氨中培养晶体的方法,这种方法与水热法生长水晶的技术类似,具有结晶质量高和易批量生产的优势。近年来,得益于生长装备技术的突破和对基本物理化学过程的理解加深,氨热法GaN单晶生长技术进展较快,有望与HVPE生长技术携手助力GaN单晶衬底市场的快速增长。
2021年5月18日,日本制铁所宣布将与三菱化学在日本室兰工厂安装一条氨热法批量生产GaN单晶衬底的示范生产线,2022年4月开始供应4英寸GaN单晶衬底。
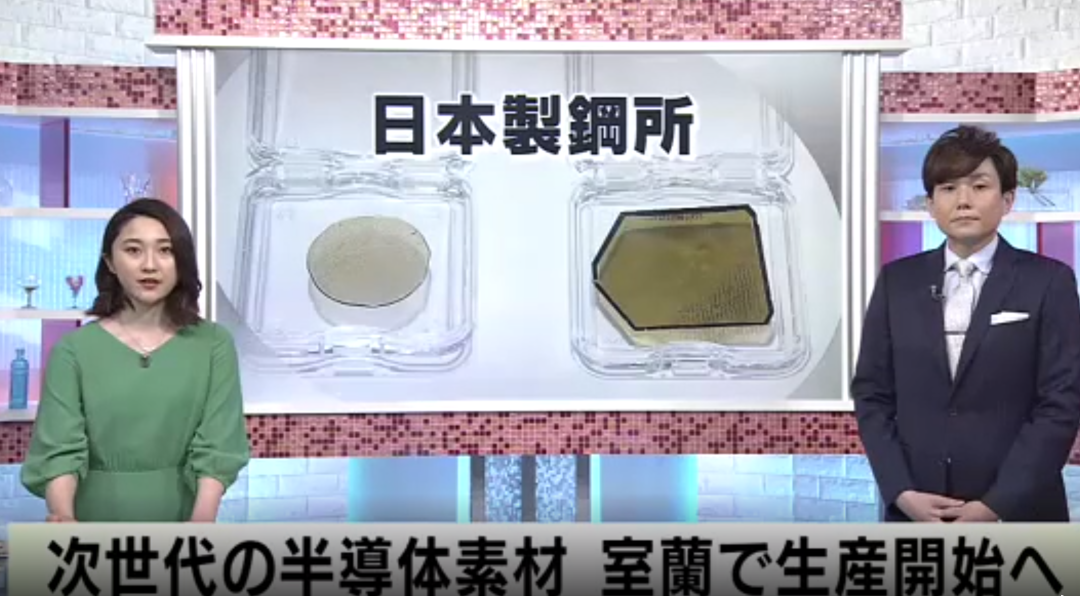
图一来源:NHK电视台报道截屏
根据三菱化学发表在Proceedings of SPIE (Vol. 11280, 1128002)的文章,他们已实现了2英寸m面和近4英寸c面GaN单晶的生长。m面GaN单晶的(10-12)和(20-20)的X射线摇摆曲线半高宽都只有6.4 arcsec,偏向角沿a向和c向分布分别为±0.009°和±0.006°,曲率半径超过400m,位错密度约为102-103cm-2,显示了极高的晶体质量。c面GaN位错密度在103cm-2量级,近4英寸c面GaN的偏向角分布沿a向和m向都是0.006°,显示了极窄的偏向角分布,有助于提高后续外延生长一致性和元素掺杂均匀性。
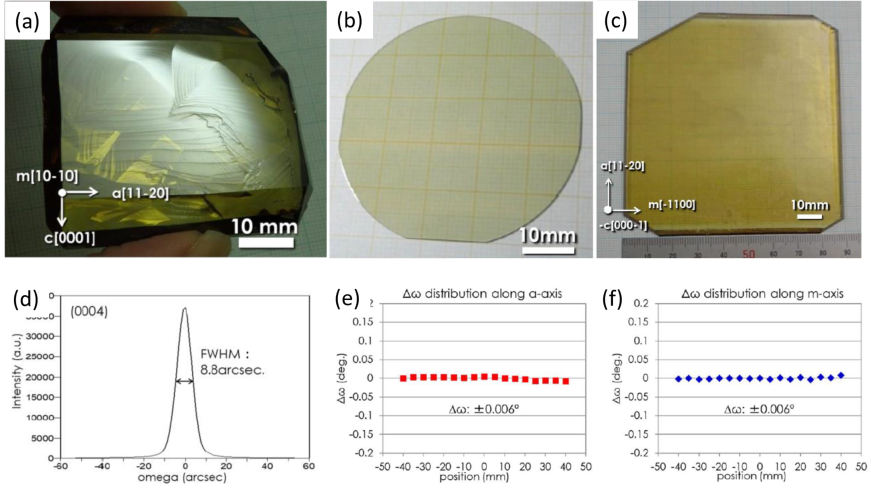
图二(a)2英寸m面GaN单晶 (b)c面抛光GaN衬底 (c)近4英寸GaN单晶 (d)(0004)X射线摇摆曲线半高宽
(e)和(f)近4英寸GaN单晶沿a向和m向偏向角分布
在此基础上,三菱化学的Kenji Iso等以c面氨热法生长的GaN为籽晶,通过HVPE法生长了高质量的GaN单晶,厚度达4.2mm,曲率半径为56m,位错密度为1.4×103cm-2。多光子荧光谱表明HVPE-GaN位错与氨热籽晶的位错呈对应关系(如图3a、b所示),比以HVPE-GaN为籽晶生长的GaN位错密度降低了三个数量级,而且应力更小,该结果发表在Applied Physics Express(Vol. 13, 085508)上。
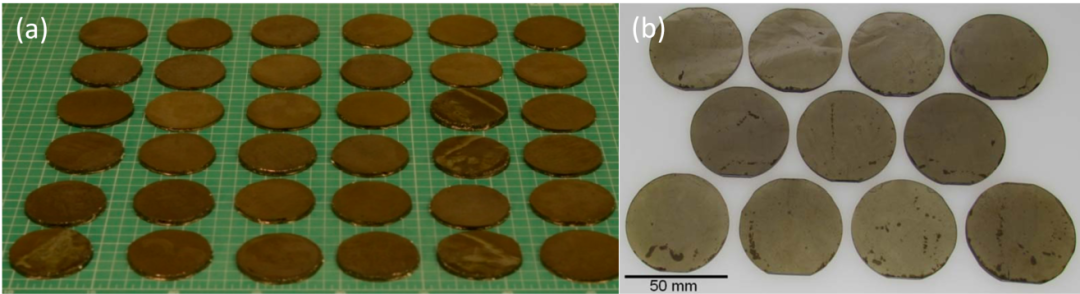
图3(a)以氨热GaN为籽晶生长的HVPE-GaN单晶(b)HVPE-GaN表面的荧光图(c)氨热籽晶界面的荧光图
根据近年来的发展态势,氨热法生长技术已体现了诸多优点:(1) 结晶质量高,位错密度比HVPE-GaN低约2-3个数量级;(2)晶格几乎无翘曲,曲率半径达数百米,有利于衬底斜切角的控制;(3)单炉产量高,易量产。目前存在主要问题有(1)大口径高压釜的制造,以满足6英寸或更大尺寸氮化镓晶体的生长;(2)需加强对氨热GaN晶体中的杂质和本征点缺陷的理解及调控,以满足各类器件对衬底电学性质的要求。
在电学性质控制方面,目前IHPP通过掺杂已经实现了n型、p型和半绝缘GaN单晶衬底;而三菱化学的研究表明利用HVPE和氨热生长技术的优势互补可解决单一生长方法存在的问题:HVPE-GaN生长速率快、纯度高,但位错密度高;氨热法GaN位错密度低、易量产,但杂质浓度高;两种生长方法的结合显著提高了GaN单晶的结晶质量和纯度,这有望成为解决GaN单晶衬底产业化的有效途径。
(文:任国强 李腾坤)





